半导体封装载板: 为每个应用场景定制的解决方案
奥特斯的半导体封装载板多年来一直是现代微电子技术的核心元件。随着半导体行业对更小型化、更高能效和更具经济性微芯片的需求不断提升,印制电路板的尺寸也在持续缩小。当数万芯片触点需要集成于极小空间时,具有高电气布线密度的积层式半导体封装载板便应运而生。半导体封装载板(集成电路基板)主要用于连接高度复杂的微芯片与印制电路板,承载存储器、电源供应及其他关键系统组件。我们载板上的导体线路现已达到仅五微米线宽,但这远未达到技术极限:奥特斯正全速研发仅两微米结构的更紧凑载板,未来将结合玻璃载体材料实现这一突破。
奥特斯半导体封装载板为集成数十亿晶体管的现代高性能处理器稳定传输数据与能量。
产品优势概览
- 载板技术是开发未来几代芯片的关键
- 玻璃基材等新材料已准备好用于进一步开发
- 奥特斯的先进技术可快速在全球范围内应用
跨越维度
倒装芯片技术作为互连与封装的基础,支撑着驱动现代计算机和数据中心的高性能半导体。该技术通过数千个焊球桥接微芯片触点与载板,这种布线方式效率卓越,可实现传统技术无法企及的触点密度。
奥特斯采用高度自动化、非接触式的先进积层工艺,所有生产均在无尘室完成。
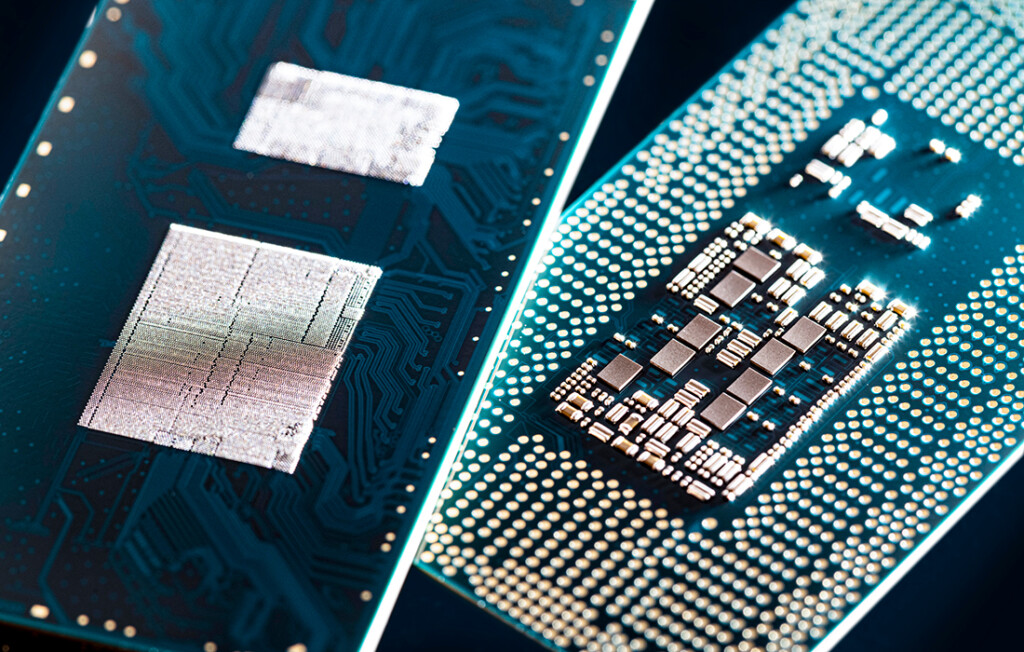
生产流程始于制造一个带有铜箔通孔的增强型芯体,该芯体作为多层绝缘介质和铜电路的构建基础。我们运用尖端技术如SAP工艺(半加成工艺),这种灵活方案完美融合了高性能、高可靠性和高性价比,是业界先进的高密度互连技术。
超级计算机和三维扫描应用
依赖载板实现系统集成的先进微芯片不仅仅应用于PC和数据中心。5G及未来6G网络需要强大电子元件才能充分发挥智能手机的网络优势,同样适用于进行气候模拟或新药研发的科研级超级计算机。部分高科技应用如环境三维扫描,也需依托搭载高性能芯片与载板的复杂传感器系统。

高性能半导体封装载板是AI设备、数据中心及云计算高效数据处理的基础。奥特斯解决方案以更低功耗,提供更强算力。

现代汽车依赖日益增多的复杂数字系统实现自动驾驶与先进安全功能。奥特斯高可靠性、高度微型化的半导体封装载板对交通系统数字化至关重要。

在人与数字技术交互之处,奥特斯半导体封装载板确保快速响应与低能耗。每颗高性能微芯片都需创新型半导体封装载板方能施展其能。
人工智能与超级计算的算力源泉
随着半导体传统微缩策略逐渐逼近极限,对载板的技术要求将持续提升。当晶体管数量无法维持”每两年翻倍”时,通过多芯片集成实现算力突破将成为关键。这需要高质量载板为各芯片稳定提供数据流与精准电压。奥特斯作为高性能载板领域的先进企业,正与优秀的半导体制造商共同开发未来芯片技术基础。
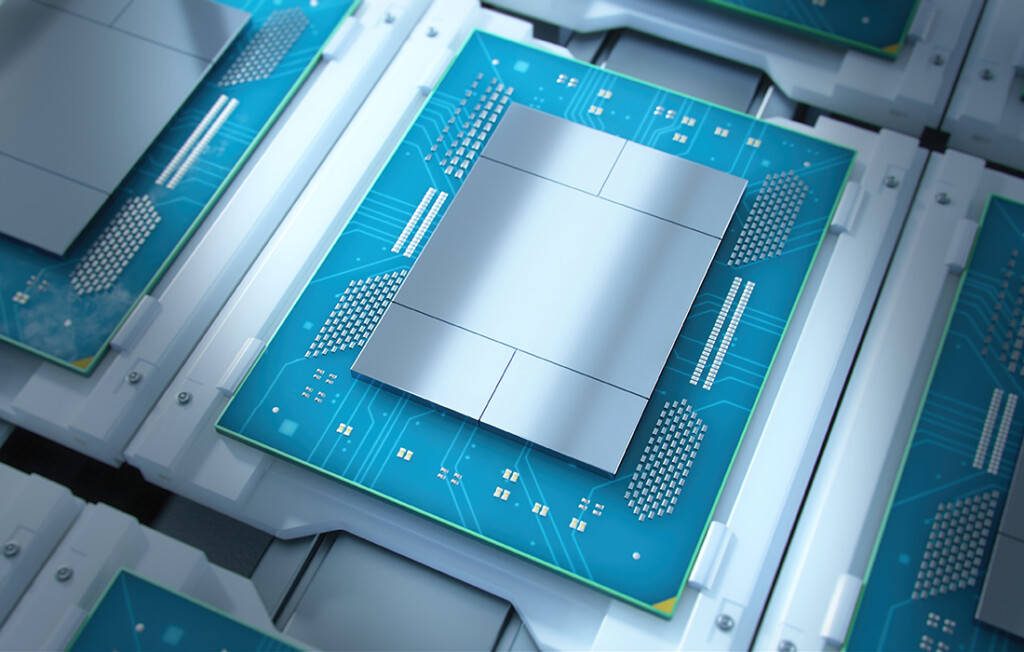
我们已开展玻璃基板材料测试,这种材料可实现更微细结构,并有效防止机械/热形变问题。此类新材料将与先进封装技术结合,实现通过单一载板为多芯片组提供高效能支持。
奥特斯提供定制化半导体封装载板解决方案,专业团队协助客户高效实现产品构想。
联系人

如果您想进一步了解我们令人兴奋的产品、技术和解决方案,我们的专家随时乐意为您提供帮助。
